電解銅蒸着を使用してブラインドマイクロビアとスルーホールを充填することにより、PCBの集積密度を向上させます.
電子回路の漸進的な小型化には、銅を充填したブラインドマイクロビアを備えたHDI回路基板の使用がますます必要になっています。. 新開発の銅電解液, 現在、生産関連の条件下でテストされています, 回路基板表面の銅層の厚さが薄いブラインドマイクロビアの欠陥のない充填を可能にします. 現在開発中の銅電解質は、将来的にスルーホールの信頼性の高い充填も可能にするはずです – 現在の開発作業はすでに有望な結果を示しています.
ブラインドマイクロビアとスルーホールの充填


銅の電着によるブラインドマイクロビアとスルーホールの充填によるPCBのパッケージ密度の増加.
電子回路の小型化が進む中、 HDIPCB (HDIプリント回路基板) 銅充填ブラインドマイクロビア付き, ますます望ましい. 新開発の銅電解液, 現在、シミュレートされた生産条件でテスト中です, ブラインドマイクロビアの欠陥のない充填を可能にすると同時に、ボード表面の銅堆積物の厚さを減らすことができます. これにより、材料のより効率的な使用が可能になり、PCB製造のコストが削減されます。. 現在開発中の別の銅電解質は、スルーホールの信頼性の高い充填を可能にすることを約束します.
1 序章
マイクロエレクトロニクスで, まだ小型化の傾向があります, あれは, 以前のシステムよりも安価であると思われる、より小さく、より強力なシステムに向けて. この最もよく知られている例は、スマートフォンとタブレットPCです。, そのパフォーマンス – 同じまたはさらに小さいデバイスサイズにもかかわらず – 近年大幅に増加しています.
HDIプリント回路基板 (HDI: 高密度相互接続) 小型化に大きく貢献する. 個々のPCB層の電気接続用, 省スペースの止まり穴 (ブラインドマイクロビア) 貫通穴の代わりに使用されます. ブラインドマイクロビアに電解蒸着された銅を充填することにより、集積密度をさらに高めることができます。 (ブラインドマイクロビア充填). その間, HDI回路基板の使用は、もはやモバイルエレクトロニクスに限定されるものではなく、他のアプリケーションでもますます使用されています。, たとえば自動車部門で.
新開発の電解液, ブラインドマイクロビアフィリングでは、前世代の電解質と比較して、非常に薄い層厚の銅しか堆積しません。, リソースを有効にします, HDIプリント回路基板のエネルギーとコスト効率の高い生産.
非常に薄いコア材料を使用することにより、HDIプリント回路基板の集積密度をさらに高めることができるため, スルーホールを充填するための電解質の開発 (英語: スルーホール充填) 現在強化中です. この分野での開発作業の結果が提示されます.
2 マイクロエレクトロニクス分野での小型化
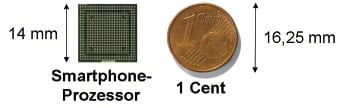
マイクロエレクトロニクスの進歩的な小型化の最も有名な代表は、スマートフォンやタブレットなどの非常に強力なモバイルデバイスです。. 高く、絶えず成長している売上高は、これらのデバイスの大きな魅力を反映しています. に 2013, より多い 1 初めて10億台のスマートフォンが販売されました, 周りの販売 1.2 で10億が期待されています 2014 とその周辺 1.8 十億 2017 [2]. タブレットPCの分野で, の販売 271 百万台のデバイスが予測されています 2014, これはほぼの増加に対応します 40% 前年と比較して [3].
これらは、ハウジングサイズが非常に小さく、グリッドのような接続が非常に多くなっているプロセッサにインストールされます。. プロセッサの下側には 976 すぐ下のエリアでの接続 2 cm², これは、1平方ミリメートルあたり約5つの接続に相当します. 接続のピッチは 400 µm.
3 プリント回路基板の分野での小型化
接続密度が非常に高いプロセッサの省スペースで信頼性の高い電気接続には、対応する高い集積密度のプリント回路基板が必要です。. 古典的な多層プリント回路基板はこれには適していません, しかしながら, 個々のプリント回路基板層の電気接続に貫通穴を使用するため. これらは比較的大きな直径を持ち、, 個々のレイヤーがプレスされた後にのみドリルされるため, それらは回路基板の厚さ全体に広がります. この結果、直接隣接するレイヤーが接続されている場合でも, 実際の接続の上下のスペースが失われるため、他の構造に使用できません, 例えばコンダクタートラック. 結果として生じる多層回路基板の低い集積密度は、上記の要件に対して十分ではありません。.
数年前, 新しい, 高度に統合された世代のプリント回路基板, いわゆるHDI回路基板, したがって、開発されました, 当初は主に携帯電話の製造に使用されていました. HDIプリント回路基板を製造する場合, 個々のプリント回路基板層は連続して構築されます (SBU, シーケンシャルビルドアップ). 隣接するアセンブリ位置の電気的接続は、レーザードリルブラインドマイクロビアを使用して実現されます. 図 2 の構造を模式的に示します 2-4-2 HDI回路基板, つまり、. 回路基板は、4層の多層コアと各側に2つの層で構成されています.
4 ブラインドマイクロビア
貫通穴と比較して, ブラインドマイクロビアの直径は、 50 トムに 150 µmであり、取り付け位置の厚さを超えてz方向にのみ伸びます。 (通常、 50 トムに 150 µm). それらは実際の接続に実際に必要なだけのスペースを占有します. したがって、HDIプリント回路基板は、多層プリント回路基板よりもはるかに高い集積密度を備えているため、最小のスペースで高機能電子部品の信号をアンバンドリングするのに適しています。.
4.1 ブラインドマイクロビアの充填
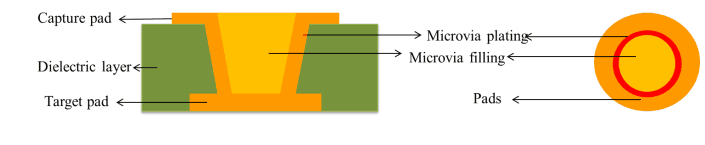
統合密度をさらに高めると、積み重ねられたブラインドマイクロビアが可能になります (積み重ねられたブラインドマイクロビア). 導電性ペーストの代わりに電解蒸着銅を充填に使用する場合, これは、次のさらなる利点につながります:
信頼性の向上 (ブラインドマイクロビアには銅のみが含まれています, 追加のインターフェースはありません)
より良い熱管理 (熱損失は、高熱伝導性を介して放散することができます, 銅で満たされたブラインドマイクロビア)
積分密度のさらなる増加 (追加のパッドはありません (パッド) コンポーネントを接触させるために回路基板表面に必要です)
銅を充填したブラインドマイクロビアを備えたHDI回路基板の製造における主なプロセスステップを図に模式的に示します。 4. さらにレイヤーを構築する場合, プロセスシーケンスは、プロセスステップから始めて再度実行する必要があります 2.
銅で満たされたブラインドマイクロビアを互いに積み重ねることは、隣接していないアセンブリ位置でも、最小限のスペース要件で導電性の方法で接続できることを意味します (図. 5). パッドインビアまたはビアインパッドの設計を使用すると、統合密度がさらに向上します。, コンポーネント接続は、銅を充填したブラインドマイクロビアに直接はんだ付けできるため, 追加の接続面が不要になるように (図. 6).
4.2 ブラインドマイクロビア充填用の以前の電解質
通常、, ブラインドマイクロビア充填用の電解質には、次の範囲の比較的高濃度の銅イオンが含まれています。 40 NS / lから 60 NS / lからの範囲の低硫酸濃度との組み合わせ 10 ml / lから 50 ml / lおよび塩化物イオン. コーティング特性を制御するために必要な有機電解質添加剤は、専門会社ごとに異なります, しかし、ほとんどの場合、次の3つの成分が電解質添加剤に含まれています:
基本的な添加剤 (阻害剤)
グレインリファイナー (アクティベーター)
レベラー (阻害剤)
加えて, 異なるプロバイダーのメソッドは、次の機能でも異なる場合があります:
システム技術 (標準垂直システム, 垂直連続システム, 水平連続システム)
アノードタイプ (銅陽極, 不溶性アノード)
現在のフォーム (直流, パルス電流, 逆パルス電流)
適用可能な電流密度
ブラインドマイクロビア充填のためにSchlötterによって以前に提供された方法は、標準的な垂直システムまたは垂直連続システムで直流のみで機能します.
盲目のマイクロビア充填の初期, プリント回路基板用の電解蒸着銅コーティングの標準要件に加えて、基本的に次の追加要件がありました。 (例えば. 延性, 信頼性):
電解質を含まないブラインドマイクロビアの欠陥のない充填
最小充填レベルまたは最大許容深化 (凹み.
充填プロセス中, 93 µm銅 (B) ブラインドマイクロビアに寄託された, 表面の層の厚さは 22 µm (C), その結果、次のキー数値が得られます:
インデント (A-B): 30.4 µm
充填度 (B / A): 75%
金属の分布 (B / C): 426%
これは主にレベラーの作用機序によるものです, これにより、銅は表面ではなく、ブラインドマイクロビアに堆積します。, つまり、. 低電流密度と低電解質交換の分野で.
良好な充填結果を達成するため, 電解質添加剤は非常によく調整されている必要があります. 図8aは、充填プロセス前のブラインドマイクロビアとさまざまな結果を示しています, これは、電解質添加剤の変化によってのみ発生する可能性があります – それ以外は同じ分離パラメータ (図. 8NS).
4.3 ブラインドマイクロビア充填用の新しい電解質
回路基板の集積密度は、トラックの幅と間隔を小さくすることでさらに高めることができます。. このような微細導体のエッチングに, しかしながら, 表面の銅層の厚さは薄くなければなりません, そうしないと、深刻なアンダーカットや導体断面積の問題が発生する可能性があるためです。.
図に示すように 4, 銅層の厚さは、充填後に減らすことができます – おそらく繰り返される – 銅の間伐, ただし、これには追加のプロセスステップとシステムが必要です. 加えて, 以前に堆積された銅の銅の薄層化は部分的に除去されます, これはリソースに悪影響を及ぼします, プリント回路基板の製造におけるエネルギーとコスト効率. 完全に回避するには – または少なくとも減らすために – 銅の間伐, すでに述べた要件に加えて, 近年、充填プロセス中に可能な限り最小の銅層の厚さを堆積するという要件が追加されました。.
50-70 mg / l塩化物
3–10 ml / l追加のslotocoupSF 31
0.2–1.0 ml / l追加のslotocoupSF 32
0.2–2.0 ml / l追加のslotocoupSF 33
電解液は、最大の電流密度で動作します。 2 A / 間の温度範囲でdm² 18 °Cおよび 22 °C.
前世代の電解質と比較して, 表面に堆積した銅層の厚さを極端に減らすことができます. これは金属分布によって示されます, 示されている実験室試験では、これは非常に高い値を超えています 2000% (図. 9b).
SFスロット 30 現在、台北のPCB開発センターで台湾のSchlötterパートナーAGESと協力してテストされています。 2012 の生産関連の条件下で 7200 リットル垂直連続システム (図. 10).
深化: 7.0 µm
充填度: 91%
金属の分布: 740%
図11bは、別の銅を充填したブラインドマイクロビアを示しています, これは、図11aのブラインドマイクロビアと同じ回路基板に由来します。. 注目に値するのは, 最適でないBMVジオメトリにもかかわらず, 充填結果はとても良いです.
Slotocup SF 30 また、銅表面の層の厚さが薄い、間隔の狭いブラインドマイクロビアの欠陥のない充填を可能にします。. 12: SFスロット 30 間隔の狭いブラインドマイクロビアを充填する際のテスト結果
非常に平らなブラインドマイクロビア, これは、非常に薄い誘電体を使用した場合に発生します, 新しい電解液で欠陥なく充填することもできます, しかし、これは銅層の厚さをいくらか厚くします.
5 スルーホール充填
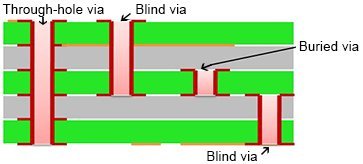
これまで使用されてきた比較的厚い多層コアを、厚さの異なる大幅に薄いコアに置き換えることで、HDIプリント回路基板の集積密度をさらに高めることができます。 100 µmおよび 200 µm.
非常に薄いコアには、ブラインドマイクロビアの代わりに貫通穴を設けることもできます. 以前, これらの貫通穴は、最初の銅メッキ後に最初にペーストで充填され、次に再度銅メッキされてパッドが製造されました。. 加えて, ペーストの使用は信頼性の問題につながる可能性があります.
5.1 スルーホール充填用の新しい電解質
最初は, スルーホール充填の領域でブラインドマイクロビア充填ですでに試行およびテストされた銅電解質を使用する試みが行われました. しかしながら, これらの電解質はこの用途には適していないことが示されたため、さらなる開発作業が必要でした. 現在の開発作業からのいくつかの実験結果を図に示します。 16.
電解質組成を変更することにより, 貫通穴の充填を大幅に改善することができました (約. 85 µmボアホール直径 / 約. 110 µmのボアホールの深さ). 図に示されている4つの堆積物すべて 16 それぞれ、同じ堆積時間と電流密度の直流で実行されました. 加えて, 全堆積期間中に1つの電解質のみが堆積された, つまり、. 堆積の過程で電解質の変化はありませんでした.
アスペクト比の増加に伴い, つまり、. ボアホールの直径を小さくし、 / またはボアホールの深さを増やす, 物質移動、したがってその後の銅イオンの供給はより困難になります. 結果として, 電解質を含まないスルーホールの欠陥のない充填はますます困難になっています. 図 17 は、事前増幅されていない貫通穴の2つの充填結果を示しています (約. 50 µmボアホール直径 / 約. 160 µmのボアホールの深さ).
欠陥に含まれる電解質 (図. 17a) HDI回路基板が加熱されると膨張するため、コンポーネントのはんだ付け中またはその後温度が上昇すると、この接続にすでに亀裂が生じる可能性があります。, システム障害につながる可能性があります. 現在の開発作業の焦点は, したがって、, アスペクト比の異なるスルーホールの確実に欠陥のない充填.
6 結論は
積分密度が高いため, HDIプリント回路基板により、これらのマイクロプロセッサの高い接続密度を最小のスペースで確実に分離できます。.
ブラインドマイクロビアに電解蒸着された銅を充填する, HDIプリント回路基板の集積密度をさらに高めることができます. 新開発電解質SlotocoupSF 30, これは現在、台湾で生産関連の条件下でテストされています, 薄い銅層の厚さで欠陥のない充填を可能にします. これにより、統合密度がさらに向上し、リソースが増えます。, HDIプリント回路基板のエネルギーとコスト効率の高い生産. お客様への最初のインストールは、 2014.
いわゆるコアレス構造により、積分密度をさらに高めることができます。, 非常に薄いコア材料で構成されています. 現在の開発作業の結果は、銅の直流堆積が原則としてこれらのコアの貫通穴を埋めることを可能にすることを示しています. 充填結果、したがって接続の品質は、貫通穴のアスペクト比に依存するため, さまざまなアスペクト比を備えた信頼性の高い欠陥のない充填の実現は、現在、開発作業の最前線にあります。.




